芯片可靠性验证RA
高温老化寿命试验(HTOL)
参考标准:JESD22-A108;
测试条件:
For devices containing NVM, endurance preconditioning must be performed before HTOL per Q100-005.
Grade 0: +150℃ Ta for 1000 hours.
Grade 1: +125℃ Ta for 1000 hours.
Grade 2: +105℃ Ta for 1000 hours.
Grade 3: + 85℃ Ta for 1000 hours.
Vcc (max) at which dc and ac parametric are guaranteed. Thermal shut-down shall not occur during this test.
TEST before and after HTOL at room, hot, and cold temperature.
高加速应力试验(HAST)
参考标准:JESD22-A110;
测试条件:
Plastic Packaged Parts
Grade 0: +175℃ for 1000 hours or +150℃ for 2000 hours.
Grade 1: +150℃ for 1000 hours or +175℃ for 500 hours.
Grades 2 to 3: +125℃ for 1000 hours or +150℃ for 500 hours.
Ceramic Packaged Parts
+250℃ for 10 hours or +200℃ for 72 hours.
TEST before and after HTSL at room and hot temperature.
* NOTE: Data from Test B3 (EDR) can be substituted for Test A6 (HTSL) if package and grade level requirements are met.
高温存储试验(HTSL)
参考标准:JESD22-A103 ;
测试条件:
Plastic Packaged Parts
Grade 0: +175℃ for 1000 hours or +150℃ for 2000 hours.
Grade 1: +150℃ for 1000 hours or +175℃ for 500 hours.
Grade 2 to 3: +125℃ for 1000 hours or +150℃ for 500 hours.
Ceramic Packaged Parts
+250℃ for 10 hours or +200℃ for 72 hours.
TEST before and after HTSL at room and hot temperature.
* NOTE: Data from Test B3 (EDR) can be substituted for Test A6 (HTSL) if package and grade level requirements are met.
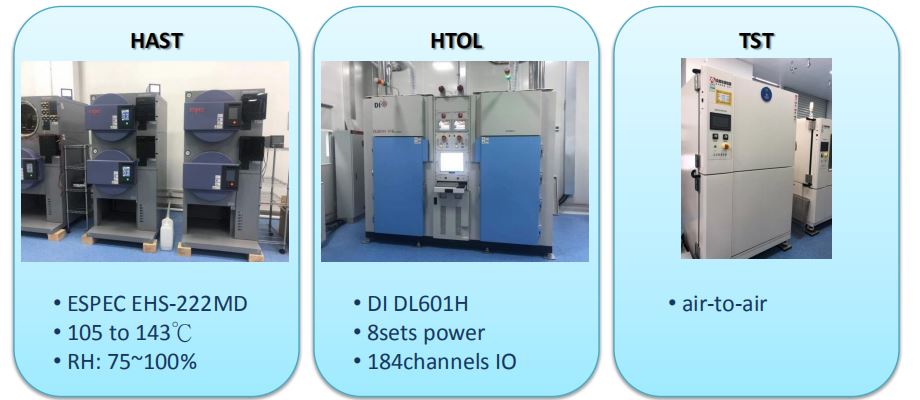
GRGT目前具有以下芯片相关测试能力及技术服务能力:
芯片可靠性验证 ( RA):
芯片级预处理(PC) & MSL试验 、J-STD-020 & JESD22-A113 ;
高温存储试验(HTSL), JESD22-A103 ;
温度循环试验(TC), JESD22-A104 ;
温湿度试验(TH / THB), JESD22-A101 ;
高加速应力试验(HTSL / HAST), JESD22-A110;
高温老化寿命试验(HTOL), JESD22-A108;
芯片静电测试 ( ESD):
人体放电模式测试(HBM), JS001 ;
元器件充放电模式测试(CDM), JS002 ;
闩锁测试(LU), JESD78 ;
TLP;Surge / EOS / EFT;
芯片IC失效分析 ( FA):
光学检查(VI/OM) ;
扫描电镜检查(FIB/SEM)
微光分析定位(EMMI/InGaAs);
OBIRCH ;Micro-probe;
聚焦离子束微观分析(FIB);
弹坑试验(cratering) ;芯片开封(decap) ;
芯片去层(delayer);晶格缺陷试验(化学法);
PN结染色 / 码染色试验;
推拉力测试(WBP/WBS);红墨水试验:
PCBA切片分析(X-section);
芯片材料分析:
高分辨TEM (形貌、膜厚测量、电子衍射、STEM、HAADF);
SEM (形貌观察、截面观察、膜厚测量、EBSD);
Raman (Raman光谱);AFM (微观表面形貌分析、台阶测量);
芯片分析服务:
ESD / EOS实验设计;
集成电路竞品分析;
AEC-Q100 / AEC-Q104开展与技术服务;
芯片测试地点:广电计量-广州总部试验室、广电计量-上海浦东试验室。
⼴电计量从1964年开始从事计量检定工作,是原信息产业部电子602计量站,历经五十余年的技术 沉淀,持续变革创新,实现跨越式发展,成⻓为⼀家全国性、综合化、J民融合的国有第三方计量检测机构,专业提供计量校准、产品检测及认证、分析评价、咨询培训、检测装备及软件系统研发等技术服务和 产品,获得了CNAS、DILAC、CMA、CATL,以及“J工四证”等政府和⾏业众多权威机构的认可资质。
依据各⾏业及领域客户的需求,⼴电计量精⼼打造出涵盖计量校准、可靠性与环境试验、电磁兼容 检测、化学分析、⻝品农产品检测、环保检测、产品认证、技术咨询与培训、质检⾏业信息化系统开发、测控产品研发的⼀站式计量检测技术服务和产品,贯穿企业品质管控全过程。

*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。